
イオンビームミリング装置は、イオン源内に生成したプラズマから引き出したイオンを加速し加工材料に衝突させ物理的に微細加工をするイオンビームエッチング装置です。
独自のバケット型イオン源により、均一で平行なビームで加工ができます。小型から大型まで取りそろえ、オーダーメイドにも対応いたします。
MEMS、センサー、MRAM、パワーデバイス、高周波デバイス、光デバイスなど、さまざまなアプリケーションに適用されており、IoTの中核となるデバイス製造を支えます。
(1)イオンの速度と衝突現象
イオンを加速して物質に衝突させると、その速度の大きさによって下図のように堆積、加工、注入などの現象が発生します。
これらの現象を利用して電子デバイスを製作することができます。
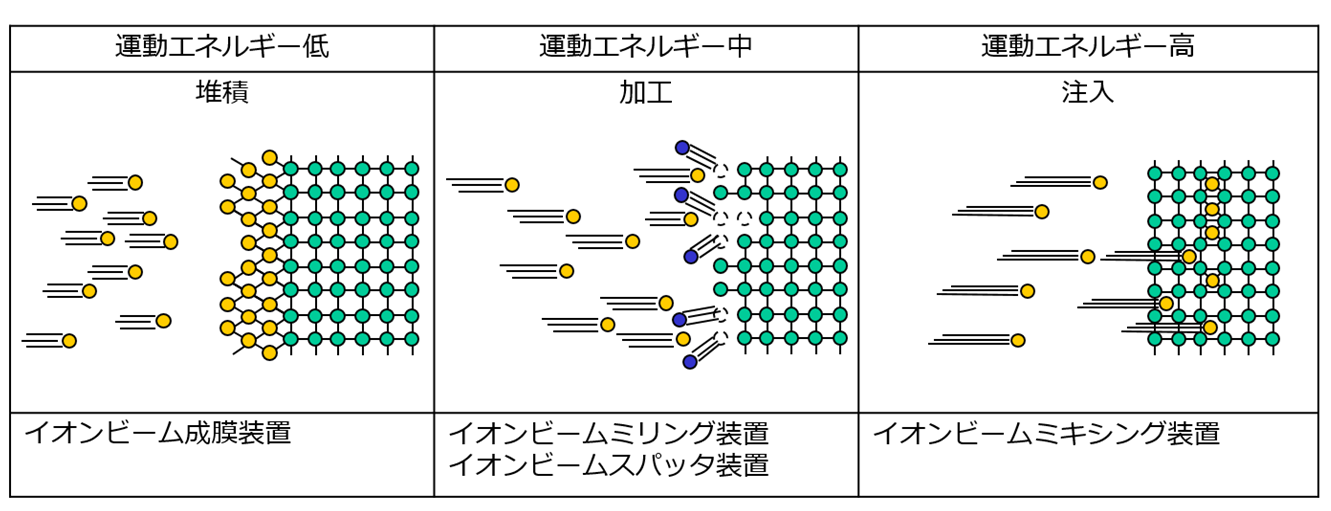
(2)イオン源のプラズマ生成
フィラメントに電流を流して熱電子を発生させ、イオン源内部にArガスを流してアーク放電を発生させると、Ar分子は熱電子と
激しく衝突して電離します。
この様にAr+イオン、電子(-)、電離していないAr分子が混在する全体として電気的に中性なArプラズマを生成します。
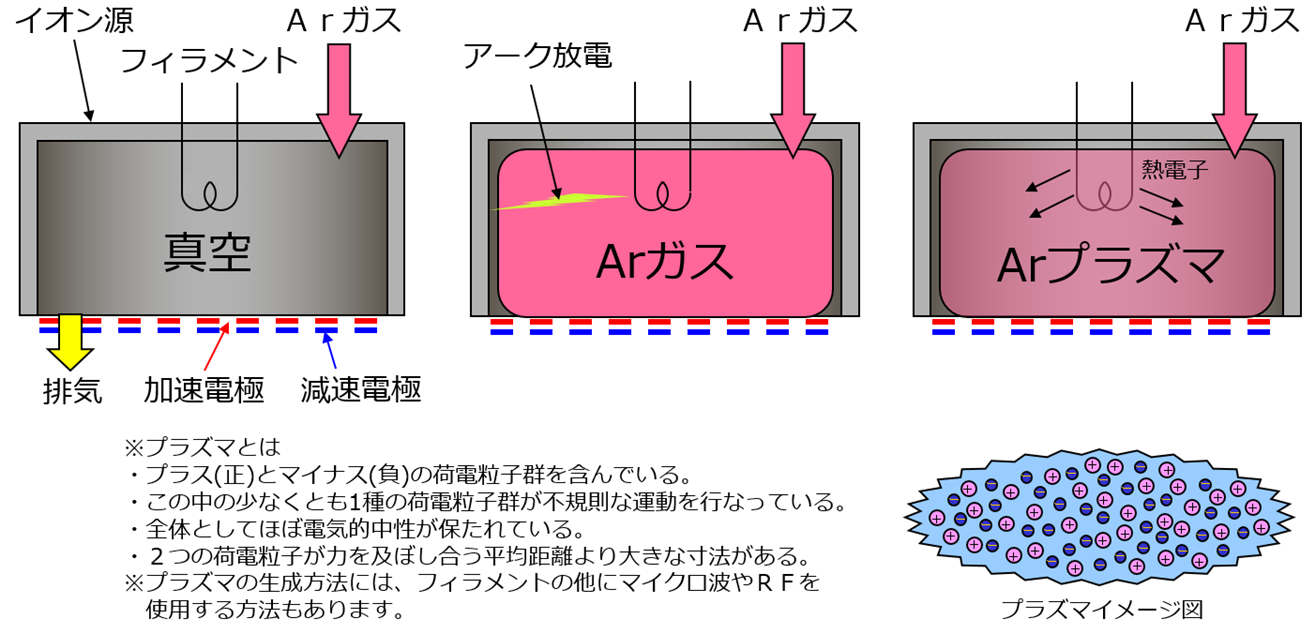
(3)イオン源からのビーム引出し
加速電極に電圧をかけることにより、電気的に中性なプラズマにプラス電位を持たせると、電極に開いている穴から漏れ出たイオンが
電位0Vの基板ホルダ方向に向かい飛んでいきます。この飛んできたイオンが加工対象である基板にぶつかることで加工を行ないます。
イオンを物理的にぶつけて加工を行なうので、ほとんどの物質を加工できます。そのため、多層膜や化学反応で削りにくい物質などの
加工に適しています。また、通常不活性ガスであるArガスのみを使用するので排ガス処理装置が不要です。

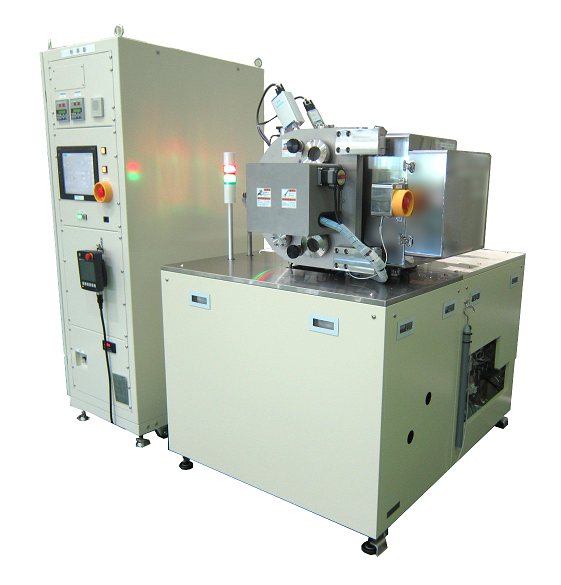
研究開発および少量生産に適した小型装置
手動取付タイプ

- エッチング高レートと低レート制御が可能
- 均一平行ビームによる高均一加工
- 難エッチング材の微細加工可能
- 立体形状のワークも加工可能
- 自転+傾斜する基板ホルダ
- 豊富なチャック方式を選択可能
- コンパクトなフットプリント
- ロードロック(オプション)
- 終点検知システム(ロードロック付タイプにオプション適用)
- エレクトロニクスデバイス、MEMS製造用、微細加工研究、開発、試作、小量産用途など
- 小型立体個体物へのイオン照射など
| 型式 | IM-150 | IM-200 | |||
|---|---|---|---|---|---|
| イオン源サイズ | Φ150 | Φ200 | |||
| イオン源電圧 | 300~1000V | ||||
| 電流密度 | ~1mA/cm~{2} | ||||
| 対象基板 | Φ4インチ×1 | Φ5インチ×1 | |||
| ホルダ動作 | 自転・傾斜 | ||||
| ホルダ冷却 | 水冷/ガス冷 | ||||
| 基板交換 | 手動 | ||||
ロードロック付タイプ
ロードロック室とトランスファーロッドを搭載したタイプ

CIMシリーズ
コンパクトをさらに追求したタイプ


カセットtoカセットで処理する量産装置
自動搬送・ロードロック室付タイプ
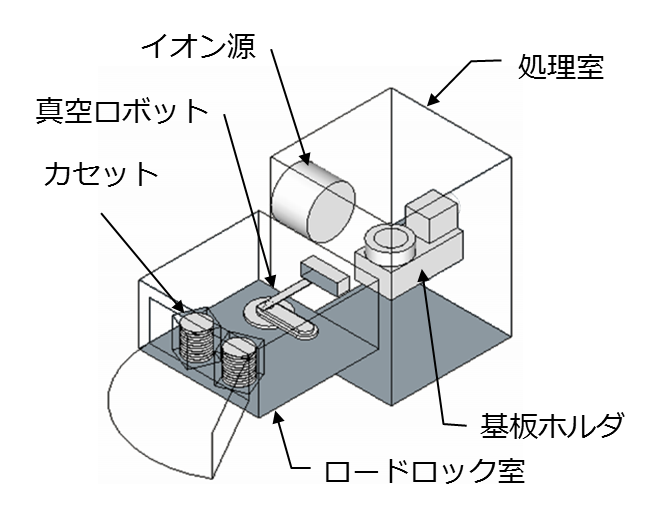
- エッチング高レートと低レート制御が可能
- 均一平行ビームによる高均一加工
- 難エッチング材の微細加工可能
- 自転+傾斜する基板ホルダ
- 豊富なチャック方式を選択可能(オプション:静電チャック)
- フィラメントレスµ波ニュートラライザ(オプション)
- 終点検知器システム(オプション)
- 反応性ガス対応(オプション)
- フィラメントレスRFバケット型イオン源(オプション)

- 拡大
- フィラメントレスµ波ニュートラライザ
(リングプラズマ)
- MEMSの電極微細加工、高周波フィルターや化合物半導体の配線・電極加工、磁気ヘッド・磁気センサーなどの微細パターン/
形状加工など
| 型式 | IML-5-1 | IML-6-1 | IML-8-1 | IML-8-2 | |||||
|---|---|---|---|---|---|---|---|---|---|
| イオン源サイズ | Φ200 | Φ250 | Φ350 | Φ300 | |||||
| イオン源電圧 | 300~1000V | ||||||||
| 電流密度 | ~1mA/cm~{2} | ||||||||
| 対象基板 | Φ5インチ×1 | Φ6インチ×1 | Φ8インチ×1 |
Φ8インチ×2 (処理室2室タイプ) (静電チェック 搭載実績あり) |
|||||
| ホルダ動作 | 自転・傾斜 | ||||||||
| ホルダ冷却 | 水冷/ガス冷 | ||||||||
処理室2室タイプ
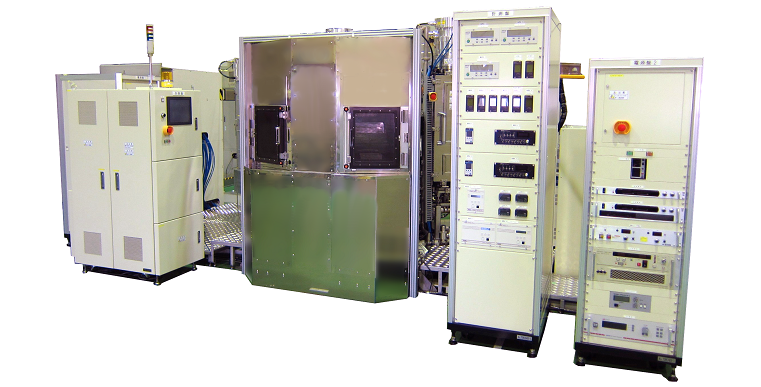
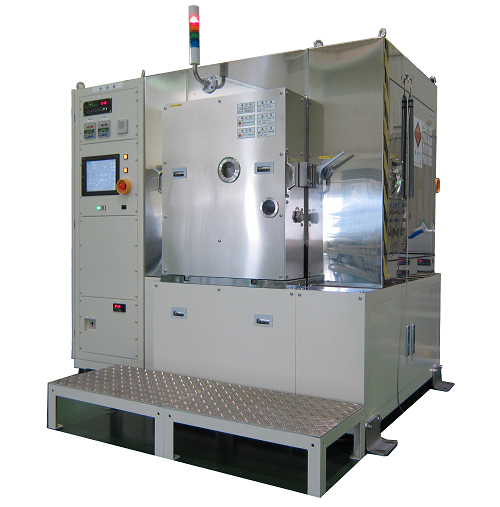
大型基板および多数枚処理に適した装置
手動取付・6枚同時処理タイプ
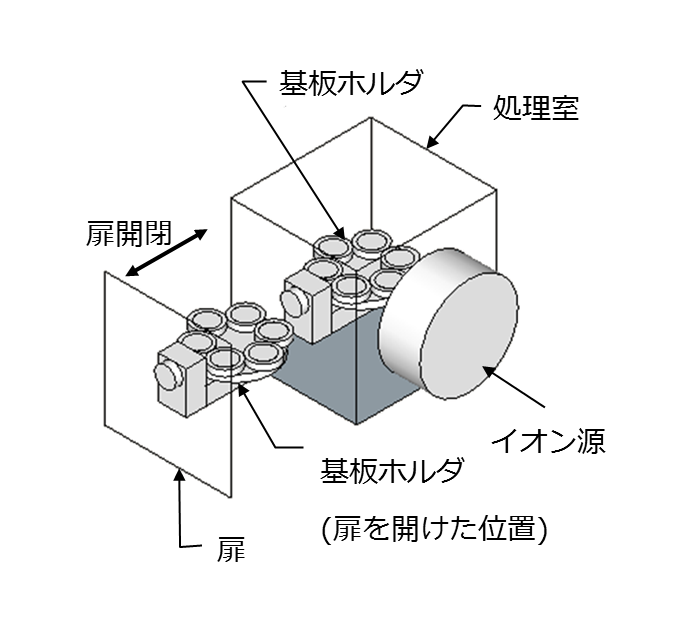
- 最大Φ580のバケット型イオン源
- 均一平行ビームによる高均一加工
- 難エッチング材の微細加工可能
- 高均一性と高スループットの両立が可能
- エッチング高レートと低レートの制御が可能
- 自公転+傾斜する基板ホルダ
- 豊富なチャック方式を選択可能
- 角形状基板など 異形基板対応、異形基板混合対応、基板サイズ兼用可能
- フィラメントレスμ波ニュートラライザ(オプション)
- 終点検知器システム(オプション)
- フィラメントレスRFバケット型イオン源(オプション)

- 拡大
- Φ580バケット型イオン源
- 磁気ヘッド用微細加工、プリンターヘッドなどの微細加工など
| 型式 | IM-580 | IML-580-LL |
|---|---|---|
| イオン源サイズ | Φ580 | Φ580 |
| イオン源電圧 | 300~1000V | |
| 電流密度 | ~1mA/cm2 | |
| 対象基板 | Φ4インチ×10 Φ5インチ×9 Φ6インチ×8 |
Φ6インチ×6 |
| ホルダ動作 | 自公転・傾斜 | |
| ホルダ冷却 | 水冷/ガス冷 | |
| 基板交換 | 手動 | カセットtoカセット |
自動搬送・ロードロック付・6枚同時処理タイプ
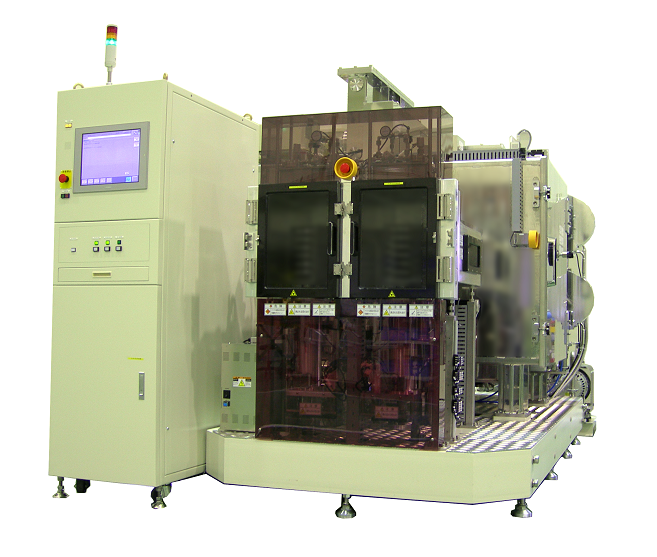
1
1

- 拡大
- 処理室内イメージ図
当社が保有するイオンビームミリング装置の各種デモ機で、お客さまの用途に合わせたサンプル処理を初回無償で提供します。
詳しくは下記までお問い合わせください。

現在、受付を一時停止させていただいております。
受付の再開につきましては、当ホームページにてご案内いたします。
大変ご不便をおかけいたしますが、何卒ご理解いただきますようお願い申し上げます。
装置ご購入後、お客様に安心してお使い頂くために保守サービスを提供します。
詳しくは下記までお問い合わせください。
イオンビーム事業に関するお問い合わせ
第2技術部
お電話でのお問い合わせ 0294-85-6038



